装置類の紹介
量子ナノラボの装置類を紹介します.
フォトリソグラフィ―装置
フォトリソグラフィーの基本事項については,こちらをご参照ください. フォトレジストは白色蛍光灯の光に感光してしまうため,これらの装置は高エネルギーの光をカットした黄色い光のもとで使用されることが多くなっております.
マスクアライナ・露光装置
設置場所:クリーンルーム内

加工したい物質をフォトマスクで覆い,マスクのオープンパターンに必要時間だけ,光を照射します. 最も簡単なもので,光学顕微鏡で観察しながらフォトマスクに対して試料を動かし,希望するパターンの露光をすることができます.
光源には水銀ランプを使用しています.
マスクレス露光装置
設置場所:クリーンルーム内
マスクレス露光については,こちらをご参照ください.
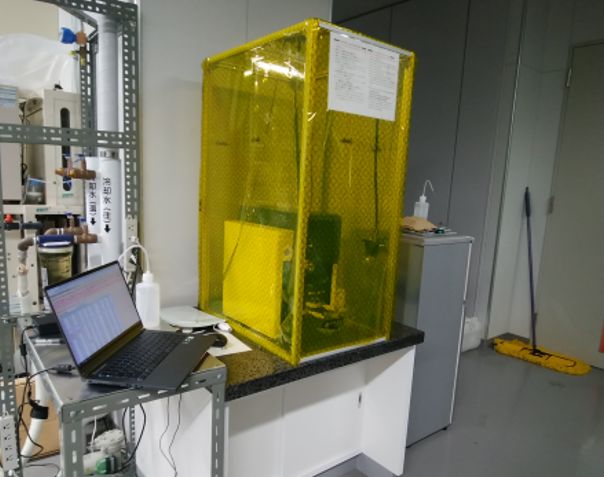
QNanoLabのマスクレス露光装置は,LED光源でDLPを使用するもので,パターンの最小サイズは3 $μ$mです. 試料ステージ移動は手動です.描画パターンのファイルフォーマットはDXFが基本ですが,実際にはjpegなどのビットマップを読み込んで使用することができます.
電子線リソグラフィー装置
電子線リソグラフィーについては,こちらをご参照ください. そこでも述べたように,電子線リソグラフィーの中心的な装置は,細く絞った電子線をパターンに合わせて試料に照射する電子線描画装置 (EB) です.電子を弾道的に飛ばす必要から,電子線源から試料まで,すべて真空の中において描画します.
EBも,様々な形態・パラメーターがあります.照射に使用する電子を生成する電子源として,多くの場合,真空中で金属電極(冷陰極,cathode)表面に高電圧(引き出し電圧)を印加し,伝導電子を真空中に引き出して電子源とします. 金属としては,タングステン(W)や6ホウ素化ランタン (LaB6)などが良く使用されます. 電子を引き出す際に,金属を加熱して金属内の高運動エネルギーの電子数を増やすと,同じ引き出し電圧でも多くの電子を引き出すことができます.この加熱補助陰極型電子源に対して,陰極金属を加熱しない,冷陰極 (cold cathode)型もあります.
電荷 \(q\) を持つ荷電粒子はローレンツ力 $$ \boldsymbol{F}=q(\boldsymbol{E}+\boldsymbol{v}\times\boldsymbol{B}) $$ を受けて運動します.\(q=-e\) の電子の運動エネルギーを増加させるためには,力が電子の速度 \(\boldsymbol{v}\) と平行方向成分を持つ電場 \(\boldsymbol{E}\) で加速する必要があります.加速電圧が大きいほど電子の運動エネルギーは高くなり,単純には,より微細な描画が可能になります.従って,EBは加速電圧によっても分類されます. 一方,軌道は磁場 \(\boldsymbol{B}\) で曲がるため,通常電場磁場の両方を用いて電子ビームを絞ったり,軌道制御します.外部からの電場磁場の影響を強く受けるため,特に常磁性金属で遮蔽しにくい磁場雑音には注意が必要です.通常は,鏡筒周りに高帯磁率物質を用いた磁気シールドが被せてあります.これを磁化させないように注意する必要があります.
また,EBの場合は走査電子顕微鏡(SEM)が,データが画像であるということを使用しての雑音低減技術が一切効きません.従って,上記ビーム制御のためのアナログ電圧などに対する要求が大変厳しくなっています.
加熱補助陰極EB (ZrO/W, ELS7700)
設置場所:地階 047

ZrO/W(WをZrOで被覆したもの)を加熱補助のカソードに使い,75 keVまでの加速電圧が使用可能なEBです.ビーム径は2 nm,10 nmまでの描画実績があります.試料ステージにはレーザー干渉計を用いており,2つの描画領域間のつなぎ精度も調整直後は10 nmとなっています. 機種型番:エリオニクス社製 ELS7700.
加熱カソードは劣化が速く,年1回程度の交換が必要です.交換には調整も含めて2週間程度の期間がかかります.
加熱補助陰極EB (LaB6, ELS3300)
設置場所:クリーンルーム

LaB6を加熱補助カソードに用い,25 keVまで(スペックは30 keV)の加速電圧が使用可能なEBです. やや古く,リニアエンコーダーを用いたステージのつなぎ精度は100 nm程度ですが,ソフトウェアによるマーカー認識自動ステージ移動に難があり,手動で行う必要があります.機種型番:エリオニクス社製 ELS3300.
冷陰極EB
設置場所:クリーンルーム

W単結晶の冷陰極を用いたSEMを,ステージやデフレクター(電子線を曲げる電磁場を発生するもの)のアンプを交換することで,EBとしての性能を持たせたものです.冷陰極から放出される電子はエネルギーの分布が狭く,比較的低加速電圧でもビームを絞ることができます.本装置では,20 nmのライン&スペース描画の実績があります. 一方,電子の引き出し効率は,陰極の表面状態に強く依存し,表面が吸着物等で覆われていると大きく低下します.冷陰極は残留ガスを吸着しやすく,引き出し効率を上げるために,電圧パルスを加えて表面から吸着分子を飛ばすフラッシングという操作を行います.フラッシング後,一定の時間が経つとビームは安定しますが,吸着分子の増加と共にビーム強度は落ちていきます. 安定してビームが出せる時間は40分間程度で,使い方を選ぶEB装置です.
SEMとしての観察像は良好で,SEMとしての使用が多くなっています.
集束イオンビーム装置
設置場所:A156 (大谷研究室)

Gaイオンをビーム状に集束し,高エネルギー(∼ 30 keV)で試料表面に入射することで,微細に切削していくことができる集束イオンビーム(FIB)加工装置です. 走査電子顕微鏡(SEM)を搭載しており,SEMで切削状況を観察しながらの加工が可能です. また,極めて微細な部分への金属蒸着など,切削以外の加工も行うことができます.
FIB加工装置の利用については,こちらをご覧の上,ご相談ください.
レジスト処理装置
レジスト処理に関して共通して使用するのは,塗布のためのスピンコーター,ベーキングのための恒温槽,ホットプレート

